- Home
- สินค้าทั้งหมด
- Product
- Products Fabs
- Micro-nano Characterization
- Scanning electron microscope and related equipment
- NTI-ArFIB 200 Argon Ion Field Emission Scanning Electron Microscope




NTI-ArFIB 200 Argon Ion Field Emission Scanning Electron Microscope
ภาพรวมผลิตภัณฑ์
NTI-ArFIB 200 Argon Ion Field Emission Scanning Electron Microscope
NTI-ArFIB 200 เป็นระบบเตรียมตัวอย่างและวิเคราะห์แบบหลายฟังก์ชันที่ผสมผสานปืนไอออนอาร์กอนแบบลำแสงกว้างเข้ากับกล้องจุลทรรศน์อิเล็กตรอนแบบส่องกราด (SEM) โดยทำลายขีดจำกัดด้วยการเชื่อมต่อระหว่างการขัดผิวตัวอย่างด้วยลำแสงไอออนแบบ in-situ และการถ่ายภาพด้วย SEM ความละเอียดสูง โดยไม่ต้องย้ายตัวอย่าง ซึ่งช่วยเพิ่มประสิทธิภาพการวิเคราะห์อย่างมาก
เทคโนโลยีลำแสงไอออนกว้างที่ติดตั้งใน NTI-ArFIB 200 มีความสามารถในการประมวลผลที่ทรงพลัง ทำให้สามารถจัดการกับตัวอย่างขนาดใหญ่ในระดับมิลลิเมตรได้อย่างง่ายดาย ซึ่งขยายขอบเขตการใช้งานได้อย่างมีนัยสำคัญ การออกแบบมุมกราดช่วยลดความเสียหายต่อตัวอย่างระหว่างการประมวลผล และรักษาความสมบูรณ์และสภาพเดิมของตัวอย่าง โมดูลการตัดชั้นระดับนาโนเมตรสามารถควบคุมความหนาของชั้นที่ถูกกำจัดได้อย่างแม่นยำ และอุปกรณ์ดักเศษที่ออกแบบมาเป็นพิเศษช่วยให้ระบบทำงานได้อย่างเสถียร และหลีกเลี่ยงการรบกวนจากเศษตัวอย่าง
NTI-ArFIB 200 เหมาะอย่างยิ่งสำหรับตัวอย่างที่ไวต่อสภาพแวดล้อมหรือมีโครงสร้างที่ซับซ้อน โดยให้โซลูชันการวิเคราะห์ตัวอย่างที่มีประสิทธิภาพและแม่นยำแก่ผู้ใช้
ทิศทางการใช้งาน
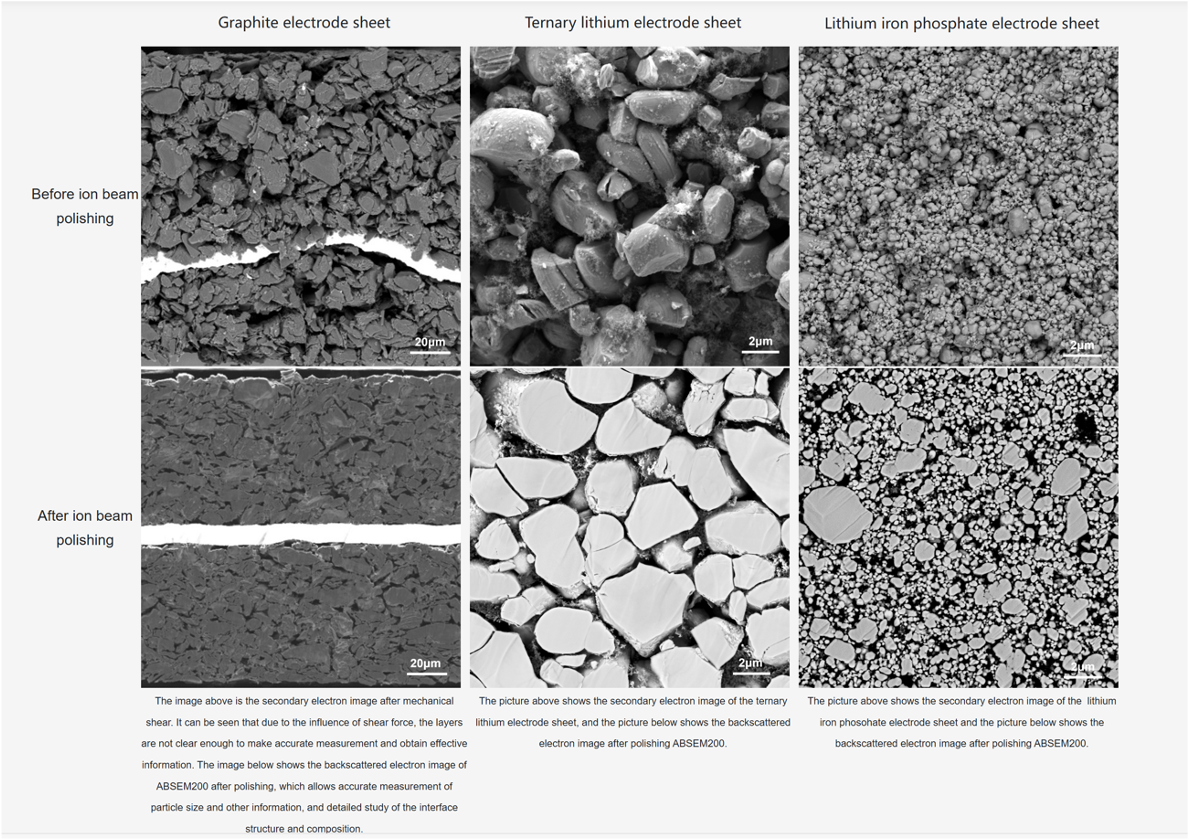
| การวิเคราะห์ความละเอียดสูง | การประมวลผลตัวอย่างขนาดใหญ่ | การควบคุมการตัดชั้นความแม่นยำสูง | การขัดผิวแบบ in-situ ที่มีประสิทธิภาพสูง |
| 1.0 nm@15 kV | สูงสุด 10mm | แท่น piezoelectric ระดับนาโน ขั้นต่ำ 8nm | การออกแบบแบบบูรณาการ ไม่ต้องย้ายตัวอย่าง |
| 1.5 nm@1 kV |
- Home Home
- About Us About Us
- All Products All Products
- Fabs Fabs
- Labs Labs
- Services Services
- Application Application
- Accessories Accessories
- News & Events News & Events
- Contact Us Contact Us
- Request Quotation Request Quotation


